盲埋孔板(Blind & Buried Vias PCB)
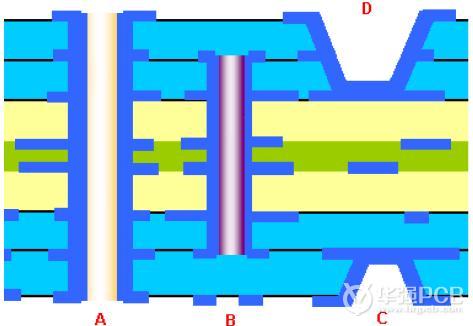
盲埋孔板 图
新客户请点击右上注册
盲埋孔板,也称为HDI板。常多用于手机,GPS导航等等高端产品的应用上。常规的多层电路板的结构,是含内层线路及外层线路,再利用钻孔,以及孔内金属化的制程,来使得各层线路之内部之间实现连结功能。随着电子产品向高密度,高精度发展,相应对线路板提出了同样的要求。而提高pcb密度最有效的方法是减少通孔的数量,及精确设置盲孔,埋孔来实现这个要求,由此应运而产生了HDI板。
埋孔也称为BURIED HOLE(外层不可看见),即为内层间的通孔,上下两面都在板子的内部,层经过压合后是无法看到,所以不必占用外层之面积。
盲孔也称为BLIND HOLE,与通孔相对而言,通孔是指各层均钻通的孔,盲孔则是非钻通孔;简单点说就是盲孔表面可以看到一面但是另一面是在板子里的我们是也看不到的,通俗的说法就是我们平时种的菜,茎叶花都是往上长的,冲破泥土,但是根须是在泥土里面的,我们看不到。
通常手机板或者导航仪器上都有用到盲孔和埋孔工艺相结合起来的板子,此类板子要求的技术含量高,精确度准。所以相对来说,对工厂的机器设备要求比普通的多层板要高出许多,相应的这类线路板的成本也会比一般的多层板要高。
目录
1 什么是盲埋孔板?
随着目前便携式产品的设计朝着小型化和高密度的方向发展,PCB的设计难度也越来越大,对PCB的生产工艺提出了更高的要求。在目前大部分的便携式产品中使0.65mm 间距以下BGA封装,均使用了盲埋孔的设计工艺,那么什么是盲埋孔呢?
盲孔(Blind vias / Laser Vias) :盲孔是将PCB内层走线与PCB表层走线相连的过孔类型,此孔不穿透整个板子。
埋孔(Buried vias):埋孔则只连接内层之间的走线的过孔类型,所以是从PCB表面是看不出来的。
一个8层板:
A:通孔(L1-L8)
B:埋孔(L2-L7)
C:盲孔(L7-L8)
D:盲孔(L1-L3)
2 盲埋孔的设置
设置Via类型:
点击菜单的Setup-Pad Stacks,再选择Pad Stack Type中的Via选项,出现如右图设置对话框。
点击左下部的Add Via按钮,进行您所需要的Via类型的设置,包括其钻孔尺寸,各层外径尺寸等等参数。
如果是通孔类型,在左下部的Vias选项中选择Through,如果是盲埋孔类型,选择Partial选项
选择Partial类型的过孔时,必须指定其起始层(Start Layer)和结束层(End Layer)。如V12和V27类型的盲埋孔设置如下图

3 PCB线路板制造流程:盲埋孔板
谈到盲/埋孔,首先从传统多层板说起。标准的多层板的结构,是含内层线路及外层线路,再利用钻孔,以及孔内金属化的制程,来达到各层线路之内部连结功能。但是因为线路密度的增加,零件的封装方式不断的更新。
为了让有限的PCB面积,能放置更多更高性能的零件,除线路宽度愈细外,孔径亦从DIP插孔孔径1 mm缩小为SMD的0.6 mm,更进一步缩小为0.4mm以下。但是仍会占用表面积,因而又有埋孔及盲孔的出现,其定义如下:
A、埋孔(Buried Via)
内层间的通孔,压合后,无法看到所以不必占用外层之面积
B、盲孔(Blind Via)
应用于表面层和一个或多个内层的连通。
1、埋孔设计与制作
埋孔的制作流程较传统多层板复杂,成本亦较高,埋孔暨一般通孔和PAD大小的一般规格。
2、盲孔设计与制作
密度极高,双面SMD设计的板子,会有外层上下,I/O导孔间的彼此干扰,尤其是有VIP(Via-in-pad)设计时更是一个麻烦。盲孔可以解决这个问题。另外无线电通讯的盛行, 线路之设计必达到RF(Radio frequency)的范围, 超过1GHz以上.。盲孔设计可以达到此需求。
盲孔板的制作流程有三个不同的方法,如下所述 :
A、机械式定深钻孔
传统多层板之制程,至压合后,利用钻孔机设定Z轴深度的钻孔,但此法有几个问题
a、每次仅能一片钻产出非常低
b、钻孔机台面水平度要求严格,每个spindle的钻深设定要一致否则很难控制每个孔的深度
c、孔内电镀困难,尤其深度若大于孔径,那几乎不可能做好孔内电镀。
上述几个制程的限制,己使此法渐不被使用。
B、逐次压合法(Sequential lamination)
以八层板为例,逐次压合法可同时制作盲埋孔。首先将四片内层板以一般双面皮的方式线路及PTH做出(也可有其它组合;六层板+双面板、上下两双面板+内四层板)再将四片一并压合成四层板后,再进行全通孔的制作。此法流程长,成本更比其它做法要高,因此并不普遍。
C、增层法(Build up Process)之非机钻方式
目前此法最受全球业界之青睐,而且国内亦不遑多让,多家大厂都有制造经验。
此法延用上述之Sequential lamination的观念,一层一层往板外增加,并以非机钻式之盲孔做为增层间的互连。其法主要有三种,简述如下:
a.Photo Defind 感光成孔式 利用感光阻剂,同时也是永久介质层,然后针对特定的位置,以底片做 曝光,显影的动作,使露出底部铜垫,而成碗状盲孔,再以化学铜及镀 铜全面加成。经蚀刻后,即得外层线路与Blind Via,或不用镀铜方式, 改以铜膏或银膏填入而完成导电。依同样的原理,可一层一层的加上去。
b.Laser Ablation 雷射烧孔 雷射烧孔又可分为三;一为CO2雷射。一为Excimer雷射,另一则为 Nd:YAG雷射此三种雷射烧孔方法的一些比较项目。
c.干式电浆蚀孔(Plasma Etching) 这是Dyconex公司的专利,商业名称为DYCOSTRATE法。
上述三种较常使用增层法中之非机钻孔式外,三种盲孔制程应可一目了然。湿式化学蚀孔(Chemical Etching)则不在此做介绍。
解说了盲/埋孔的定义与制程,传统多层板应用埋/盲孔设计后,明显减少面积的情形。
埋/盲孔的应用势必愈来愈普遍,而其投资金额非常庞大,一定规模的中大厂要以大量产,高良率为目标,较小规模的厂则应量力而为,寻求利基(Niche)市场。






